將系統級封裝概念推向未來
Chipletz 選用 Siemens 半導體封裝 技術,設計其基於 Smart Substrate 的獨特先進封裝
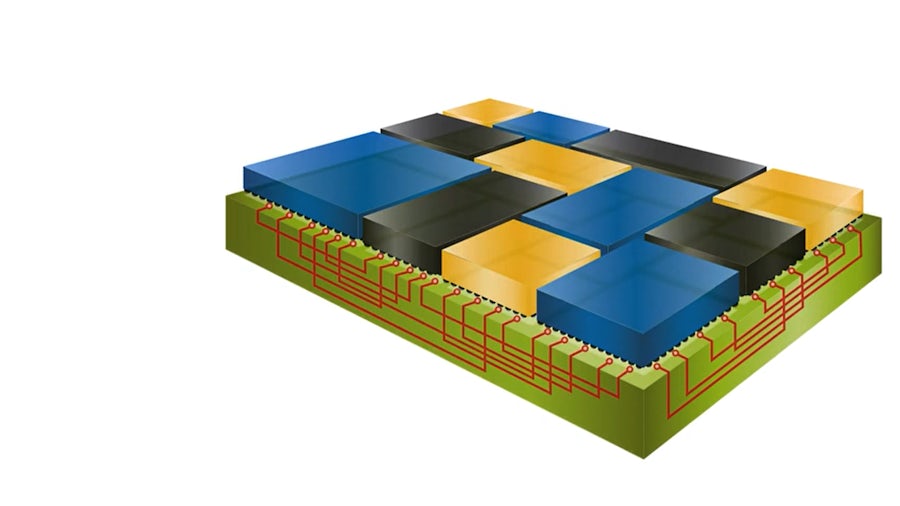
Chipletz
Chipletz 成立於 2021 年,是一家無晶圓基板廠商,致力開發先進封裝技術,以填補摩爾定律發 展速度放緩與運算效能需求不斷增加兩者間之間的差距。該公司的 Smart Substrate 產品可幫助 將多個 IC 整合到一個封裝中,以支援關鍵 AI 工作負載、沉浸式消費者體驗和高效能運算。 Chipletz 計劃在 2024 年初為客戶及合作夥伴交付自家初始產品。
- 總部:
- 得克薩斯州奧斯汀, United States
- 產業領域:
- Electronics, Semiconductor devices
選擇 Siemens 是因為他們展現了卓越的技術能力,並在先進異質半導體封裝設計方面擁有豐富的專業知識。
願景
Chipletz 是由來自 Advanced Micro Devices, Inc. (AMD) 和其他主要系統供應商的業界資深人士出資成立的一家新創公司。他們的願景是透過開發先進的封裝技術,將半導體封裝內的功能徹底革新,以填補摩爾定律發展速度放緩與運算效能需求不斷增加這兩者間的差距。Chipletz 的 Smart Substrate 產品可幫助以異質方式將多個 IC 整合到一個封裝中,以支援關鍵 AI 工作負載、沉浸式消費者體驗和高效能運算。
Chipletz 技術專精的工程師團隊在半導體設計、製造和封裝方面擁有數十年經驗,能滿足此一需求。Chipletz 正在將系統級封裝概念推向未來,為未來數年的額外效能提升開闢一條前進之路,同時讓半導體整合的經濟模式重新洗牌。Chipletz 以 Smart Substrate為基礎的獨特平台,讓幾乎任何製造商的任何晶粒都能整合在一起。
-640x360.jpg?auto=format,compress&w=843&q=60)
Chipletz 技術長 Michael Su and Chipletz 執行長 Bryan Black
Smart Substrate 提供晶粒至晶粒互連及高速I/O,並支援從單一電源提供不同的電壓域,勝過現有的多晶片模組和系統級封裝選擇。
Chipletz 技術長 Michael Su 說:「基於我們的 Smart Substrate 進行設計對設計師及其設計工具提出了許多具有挑戰性的要求。在評估 EDA 供應商和他們的技術時,這些要求是我們評估的重點依據。」
Chipletz 使用的關鍵選擇標準可總結如下:
- 支援高頻寬記憶體 (HBM) 通道設計
- 在採用超大型連線關係結構的龐大設計上,仍具有互動性
- 先進的基板透氣孔添加能力
- 利用重複使用來建立複雜的電源與接地結構
- 設計工具和設計流程的自動化及客製化
- 能夠開發客製化的 Smart Substrate 專用的設計規則檢查 (DRC)
- 供應商領域專業知識和技術資源的可用性及可信度
為了評估 Siemens Xpedition™ 半導體封裝技術,Chipletz 使用一個巨型 SoC 設計,兩側搭配四個 HBM 堆疊,並在 Smart Substrate 中整合去耦電容器。元件尺寸約為 50 mm x 65 mm,總共 8000 多個 net 使用大約 120 萬個過孔連接晶粒,並在一個含有 2800 個錫球的 BGA 上使用超過 18 萬個元件腳位。此設計使用 Smart Substrate技術打造而成,並利用了 150 多個重複使用電路,使得金屬層減到只有 9 層,而前一版使用的矽中介層需要 16 層金屬。
-640x360.jpg?auto=format,compress&w=843&q=60)
Chipletz Smart Substrate
Chipletz 透過許多使用案例情境對 Siemens 的技術和技術專家執行了廣泛的評估,以確認解決方案是否適合未來的多晶粒異質設計。作為此次評估的結果,Chipletz 選用了 Siemens 的半導體封裝技術,設計以 Smart Substrate 為基礎的獨特先進封裝。
Chipletz 執行長 Bryan Black 表示:「作為無晶圓基板廠商和小晶片整合商,我們開發出先進的封裝技術,以填補摩爾定律發展速度放緩與運算效能需求不斷增加這兩者間的差距。選擇 Siemens 是因為他們展現了卓越的技術能力,並在先進異質半導體封裝設計方面擁有豐富的專業知識。」
自從選擇 Siemens 後,該團隊按計劃完成了第一個設計,並對他們在合作夥伴、供應商和技術方面做出的正確選擇繼續感到滿意。
Chipletz 預期他們接下來將著重於熱與熱致機械應力領域,Siemens 在這兩個領域以成熟的技術領先群倫。
-640x360.jpg?auto=format,compress&w=843&q=60)
基於我們的 Smart Substrate 進行設計對設計師及其設計工具提出了許多具有挑戰性的要求。在評估 EDA 供應商和他們的技術時,這些要求是我們評估的重點依據。